Cu CMP slurry의 구성요소가 CMP결과에 미치는 영향
Cu CMP 공정은 ILD와 STI 공정에 비해서 슬러리에 의한 화학적인 요소에 많은 영향을 받는다.
Cu CMP용 슬러리는 크게 complexing agent(or chelating agent), oxidizer, corrosion inhibitor, abrasive, pH adjustor로 구성되어 있으며 그 각각의 복합작용에 의하여 재료를 제거하게 된다. 따라서 Blanket Cu wafer를 이용하여 각각의 슬러리 구성요소가 연마결과에 어떠한 영향을 미치는지에 관하여 연구해 볼 필요가 있다.

Cu CMP slurry의 구성요소가 Cu pattern wafer의 연마에 미치는 영향
앞선 blanket wafer의 실험에서 얻은 결과를 바탕으로 Cu pattern wafer의 연마 시, 슬러리 구성요소들이 어떠한 역할을 하는지에 관하여 알아보고자 하였다.
Cu pattern wafer의 연마에 앞서 blanket wafer를 이용 기초 실험을 토대로 패턴의 피치(pitch)와 밀도(density)의 변화에 따라 어떠한 연마특성을 가지는지에 관하여 연구하고 있다.
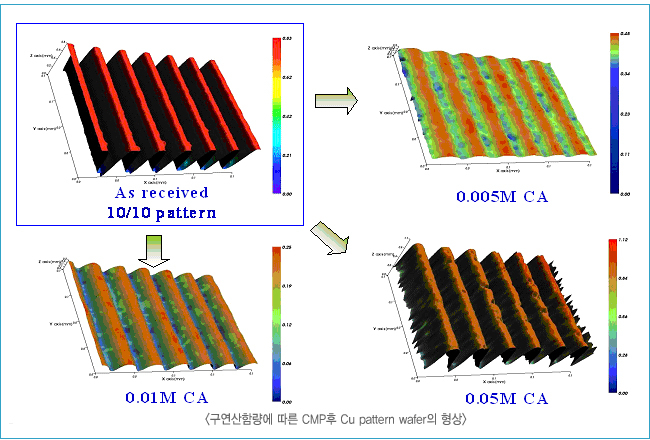
 CMP 실험실
CMP 실험실