Electro-chemical Mechanical Deposition(ECMD)
배선 물질을 배선구조에 충진 시 불균일한 표면층에 의하여 Cu CMP 시 디싱(dishing)과 에로젼(erosion) 등과 같은 결함들이 발생한다. 즉, 충진 시 발생하는 불균일한 단차에 의하여 Cu CMP에 의한 연마제거량은 증가하게 되며 디싱과 에로젼과 같은 결함의 문제로 인하여 웨이퍼 내의 불균일도가 나쁘게 된다.
이러한 결함들을 감소시키기 위하여 전기화학적으로 배선 물질을 충진하면서 기계적 작용을 통한 평탄화를 이루는 전기화학 기계적 도금(ECMD)에 관한 연구가 진행되고 있다.
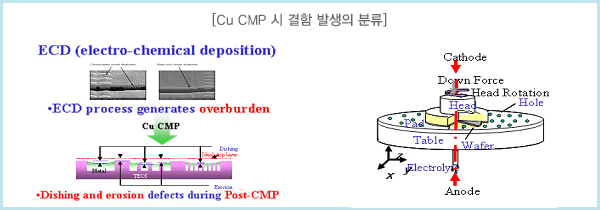
전기화학 기계적 도금(ECMD)의 특성평가
ECMD 공정은 전기화학, 기계적 작용을 통하여 Cu를 패턴 내에 도금하는 동시에 연마패드에 의한 웨이퍼 패턴 상층부에 직접 접촉하여 평탄화하는 공정이다.
전기화학적 도금(ECD : Electro-Chemical Deposition) 공정은 종횡비(aspect ratio)가 다르거나 패턴 밀도에 따라서 불균일하게 도금이 되어지지만 ECMD 공정은 종횡비와 패턴 밀도에 상관없이 균일한 표면층을 얻을 수 있다.

전기화학 기계적 도금(ECMD)의 이점
ECMD 공정은 다음과 같은 이점들이 있다.
- 다이(die) 또는 웨이퍼 스케일에서 더미(dummy) 구조가 필요없이 국부적/광역적 평탄화 달성
- 후속 CMP 공정에서 디싱과 에로젼과 같은 결함들의 최소화
- 도금액의 재사용 및 후속 CMP 공정에서의 공정시간 단축 및 과연마(over-polishing)의 감소로 인한 소모품 비용 최소화
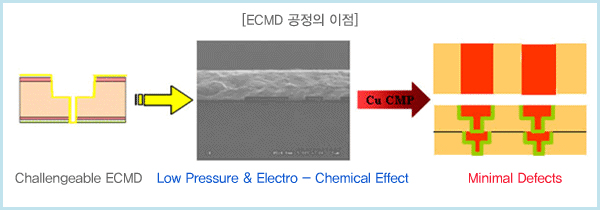
 CMP 실험실
CMP 실험실